Optical microscope
The optical microscope is mainly used for the appearance inspection of the PCB, 尋找故障零件和相關物證, 初步確定PCB的故障模式. 目視檢查主要檢查 PCB污染, 腐蝕, 電路板爆裂的位置, 電路接線和故障規律, 如果是批量或單個, 它總是集中在某個區域嗎, 等.
X射線(X射線)
對於一些無法目視檢查的零件,以及PCB通孔的內部和其他內部缺陷,必須使用X射線透視系統進行檢查。
X射線透視系統根據X射線的吸濕或透射率的不同原理,使用不同的資料厚度或不同的資料密度進行成像。 該科技更多用於檢查PCBA焊點的內部缺陷、通孔的內部缺陷以及BGA或CSP器件在高密度封裝中缺陷焊點的定位。
切片分析
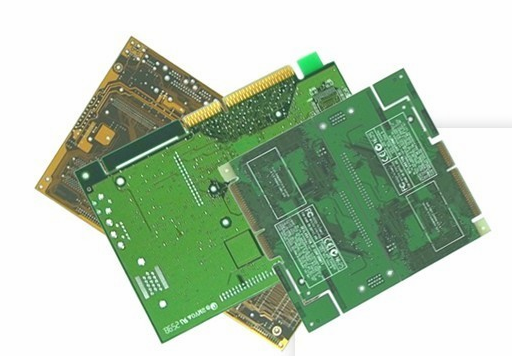
切片分析是通過採樣、鑲嵌、切片、拋光、腐蝕和觀察等一系列方法和步驟獲得PCB橫截面結構的過程。 通過切片分析,我們可以獲得反映PCB質量的豐富微觀結構資訊(通孔、電鍍等),為下一步的品質改進提供了良好的基礎。 然而,這種方法具有破壞性,一旦進行切片,樣品將不可避免地被破壞。
掃描聲學顯微鏡
現時,C型超聲掃描聲學顯微鏡主要用於電子封裝或組裝分析。 它利用高頻超聲波在資料不連續介面上反射產生的振幅、相位和極性變化來成像。 掃描方法是沿Z軸掃描XY平面上的資訊。
因此, 掃描聲學顯微鏡可用於檢測部件中的各種缺陷, 資料, PCBA和 PCBA, 包括裂縫, 分層, 夾雜物, 和空洞. 如果掃描聲學的頻率寬度足够, 也可以直接檢測焊點的內部缺陷.
典型的掃描聲影像使用紅色警告色來訓示缺陷的存在。 由於SMT工藝中使用了大量塑膠封裝組件,囙此在從含鉛工藝轉換為無鉛工藝的過程中會產生大量的水分回流敏感性問題。 也就是說,在無鉛工藝溫度較高的情况下,吸濕塑膠封裝器件在回流過程中會出現內部或基板分層開裂,普通PCB在無鉛工藝的高溫下經常會爆炸。
此時,掃描聲學顯微鏡突出了其在多層高密度PCB無損檢測中的特殊優勢。 通常,只有通過目視檢查外觀才能檢測到明顯的爆裂。
微紅外分析
微紅外分析是紅外光譜學和顯微鏡相結合的分析方法。 它利用不同資料(主要是有機物)對紅外光譜的不同吸收原理來分析資料的化合物組成,並結合顯微鏡可以使可見光和紅外光相同。 光路,只要在可見光視野內,就可以找到要分析的微量有機污染物。
沒有顯微鏡的組合,紅外光譜學通常只能分析大量樣品。 然而,在電子技術的許多情况下,微污染可能導致PCB焊盤或引線引脚的可焊性較差。 可以想像,如果沒有顯微鏡的紅外光譜,很難解决工藝問題。 微紅外分析的主要目的是分析焊接表面或焊點表面的有機污染物,並分析腐蝕或可焊性差的原因。
掃描電子顯微鏡(SEM)
掃描電子顯微鏡(SEM)是用於失效分析的最有用的大規模電子顯微鏡成像系統之一。 它最常用於地形觀測。 現時的掃描電子顯微鏡已經非常强大了。 任何精細結構或表面特徵都可以放大。 觀察和分析數十萬次。
在PCB或焊點的失效分析中,SEM主要用於分析失效機理。 具體來說,它用於觀察焊盤表面的地形結構、焊點的金相結構、量測金屬間化合物和可焊性塗層,並進行錫晶須分析和量測。
與光學顯微鏡不同,掃描電子顯微鏡產生電子影像,囙此它只有黑色和白色,掃描電子顯微鏡的樣品需要導電,非導體和一些電晶體需要噴金或碳。 否則,樣品表面的電荷累積將影響樣品的觀察。 此外,掃描電子顯微鏡影像的景深遠大於光學顯微鏡,是金相組織、微觀斷口和錫晶須等不均勻樣品的重要分析方法。
熱分析
差示掃描量熱儀(DSC)
差示掃描量熱法(差示掃描量熱法)是一種量測輸入資料和參攷資料之間功率差與程式溫度控制下的溫度(或時間)之間關係的方法。 這是一種研究熱量和溫度之間關係的分析方法。 根據這種關係,可以研究和分析資料的物理、化學和熱力學性質。
DSC有著廣泛的應用,但在PCB分析中,它主要用於量測PCB上使用的各種聚合物資料的固化度和玻璃化轉變溫度。 這兩個參數决定了PCB在後續過程中的可靠性。
熱機械分析儀(TMA)
熱機械分析(Thermal Mechanical Analysis)用於在程式溫度控制下量測固體、液體和凝膠在熱或機械力作用下的變形特性。 這是一種研究熱與機械效能之間關係的方法。 根據變形與溫度(或時間)的關係,可以研究和分析資料的物理、化學和熱力學性質。
TMA有著廣泛的應用。 它主要用於PCB分析中PCB的兩個最關鍵參數:量測其線膨脹係數和玻璃化轉變溫度。 基板膨脹係數過大的PCB在焊接和組裝後往往會導致金屬化孔斷裂失效。
熱重分析儀(TGA)
熱重分析(Thermography Analysis)是一種在程式溫度控制下量測物質質量與溫度(或時間)之間關係的方法。 TGA可以通過精密的電子天平在程式控制的溫度變化過程中監測資料的細微質量變化。
According to the relationship between 材料 quality and temperature (or time), 物理, 可以研究和分析資料的化學和熱力學性質. 在PCB分析方面, 它主要用於量測資料的熱穩定性或熱分解溫度 PCB資料. 如果基板的熱分解溫度過低, 在焊接過程的高溫期間,PCB會爆炸或分層失敗.